Учитывая потребности огромного и постоянно увеличивающегося парка вторичных источников питания, где всё более доминируют импульсные преобразователи, то можно отметить, что одной из актуальных задач является снижение мощности потерь, то есть повышение КПД.
Для решения данной задачи многие зарубежные и ряд отечественных предприятий осуществляют разработку новых полупроводниковых приборов, как на основе кремния, так и на основе других известных полупроводниковых материалов, например таких, как арсенид галлия, нитрид галлия, карбид кремния.
Причины ограниченных возможностей кремниевой элементной базы заключаются в свойствах исходного материала – кремния, технологических и электрофизических параметрах приборных структур, сильно выраженной зависимости быстродействия от температуры при эксплуатации.
Одним из возможных материалов для разработки и изготовления быстродействующих приборов может выступать арсенид галлия. GaAs – материал, сочетающий преимущества Si (технология получения, формирование приборных структур) и SiC – широкий диапазон рабочих температур (до 250 oC), широкий диапазон рабочих частот – десятки и сотни ГГц, вполне оправданно занимает нишу между Si и SiC. Не претендуя на замену ни Si, ни SiC, GaAs позволяет достаточно технологично и относительно недорого изготавливать широкую гамму полупроводниковых приборов, начиная от маломощных [1] и, заканчивая, силовыми полупроводниковыми приборами [2].
В этой связи, перспективным направлением является разработка и иизготовление высоковольтных быстродействующих транзисторов на основе AlGaAs/GaAs – гетероэпитаксиальных структур, ориентированных на применение во вторичных источниках питания.
На основе требований к элементной базе импульсной техники можно сформулировать основные требования к высоковольтным гетероструктурным транзисторам (Таблица 1).
Таблица 1
|
Параметр |
Значение |
| Статический коэффициент передачи тока в схеме ОЭ при UКБ = 5 В, IЭ = 2 А | > 20 |
| Граничная частота коэффициента передачи тока в схеме ОЭ при UКБ = 5 В,
IК = 50 мА |
> 4 МГц |
| Граничное напряжение при IЭ = 0,1 А | > 200 В |
| Напряжение насыщения коллектор-эмиттер при IК = 2 А, IБ = 0,08 А | < 0,5 В |
| Напряжение насыщения база-эмиттер при IК = 2 А, IБ = 0,08 А | < 1,2 В |
| Время включения при UКЭ = 200 В, IК = 2 А, IБ = 0,08 А | < 0,6 мкс |
| Время выключения при UКЭ = 200 В, IК = 2 А, IБ = 0,08 А | < 1,6 мкс |
| Рабочий диапазон температур | -60 ‒ +200 oC |
Достижения в области разработки, производства и применения быстродействующих полупроводниковых приборов, в том числе силовых биполярных транзисторов связаны не только с достижениями кремниевой технологии, но с использованием ряда других полупроводниковых материалов. Особенно, как говорилось ранее, это касается арсенида галлия [3]. Научные и технологические достижения в области получения многослойных эпитаксиальных гетероструктур с применением процессов жидкофазной (ЖФЭ), газофазной (ГФЭ) и молекулярно-лучевой (МЛЭ) эпитаксий позволяют практически реализовать преимущества этого материала.
Наиболее универсальными, технологичными и относительно недорогими методами получения GaAs-гетероструктур являются методы ЖФЭ и ГФЭ. Доступность данных методов заключается в том, что такие процессы имеется на ряде Российских предприятий. Комбинацией методов ЖФЭ и ГФЭ можно получить многослойные эпитаксиальные гетероструктуры с разным типом проводимости и толщинами от нескольких десятков нанометров до нескольких десятков микрометров. Это даёт возможность исследования и последующей разработки биполярных транзисторов в широком диапазоне рабочих напряжений, начиная от единиц вольт и заканчивая несколькими сотнями вольт.
В данной работе исследована возможность разработки и изготовления высоковольтного AlGaAs/GaAs-гегероструктурного n-p-n – транзистора [4].
Характерной особенностью таких приборов является наличие слаболегированной эпитаксиальной плёнки, выращенной методом ЖФЭ на низкоомной подложке. Далее методами ГФЭ выращены базовые слои. В завершение, методами ГФЭ наращивается AlGaAs/GaAs – гетероструктурный эмиттер (рис. 1).
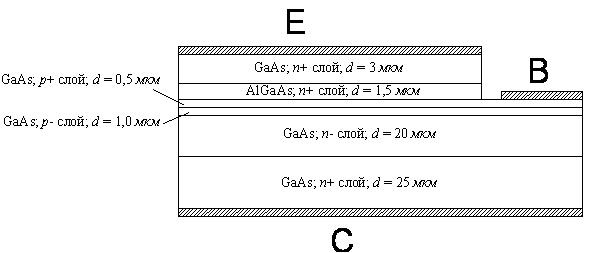
Рис. 1 — Послойная структура n—p—n – AlGaAs/GaAs гетеротранзистора
В таком транзисторе с высокоомным коллектором, базу необходимо сделать в виде двух эпитаксиальных слоёв. Первый слой, со стороны коллектора – высокоомный, для обеспечения максимального напряжения «коллектор-эмиттер» и второй слой – низкоомный, для компенсации эффекта вытеснения эмиттерного тока при высокой его плотности, а также для уменьшения модуляции базы (эффекта Эрли). Такое решение позволяет предотвратить прокол базы и даёт возможность реализовать преимущества уменьшения размеров p-области для повышения быстродействия приборов и коэффициента передачи эмиттерного тока. Однако концентрация дырок в базе для транзисторов с однородными p—n — переходами принципиально ограничена уровнем порядка 5·1017 см-3, что определяется границей легирования эмиттера (NE=5·1018÷1019 см-3). Для преодоления данной проблемы собственно и применяют гетеропереходы.
В гетероструктурном n—p—n — транзисторе ширину базы и ширину эмиттера в первом приближении можно оценить исходя из соотношения, связывающего коэффициент усиления тока с уровнями легирования базовой и эмиттерной областей, а также с размерами данных областей [5].


Все приведённые в данном разделе соотношения носят приближённый характер и позволяют синтезировать исходную многослойную эпитаксиальную транзисторную гетероструктуру, приведённую на рис. 1.
Точный расчёт был проведён с применением компьютерных вычислительных средств. В дальнейшем, результаты расчёты были сопоставлены с данными исследования экспериментальных образцов транзисторов.
Концентрационный профиль примеси в структуре транзистора показан на рис. 2.

Рис. 2 – Результирующий концентрационный профиль примеси в структуре транзистора
На рис. 3 показана выходная ВАХ транзистора, на рис. 4 показана выходная ВАХ в области малых напряжений при базовом токе IБ = 80 мА. По горизонтальной оси отложено напряжение коллектор-эмиттер UКЭ в вольтах, по вертикальной оси – ток коллектора IК в амперах.
Переход из режима насыщения в активный режим осуществляется при напряжении UКЭ порядка 1,2 В. Резкое нарастание коллекторного тока и, соответственно, переход транзистора в режим пробоя осуществляется при напряжении UКЭ порядка 200 В. Коэффициент усиления b » 50.

Рис. 3 – Выходная ВАХ транзистора при базовом токе IБ = 80 мА
На рис. 5 показаны графики напряжений переходного процесса включения и выключения транзистора. По горизонтальной оси отложено время в секундах, по вертикальной оси – напряжение в вольтах. На рис. 6 показаны графики токов процесса включения и выключения транзистора. По горизонтальной оси отложено время в секундах, по вертикальной оси – ток в амперах. Из этих графиков можно определить граничное напряжение, напряжения насыщения и временные параметры транзистора.
Граничное напряжение UКЭ0,гр = 300 В. Таким образом, граничное напряжение UКЭ0гр выше указанного в табл. 1.
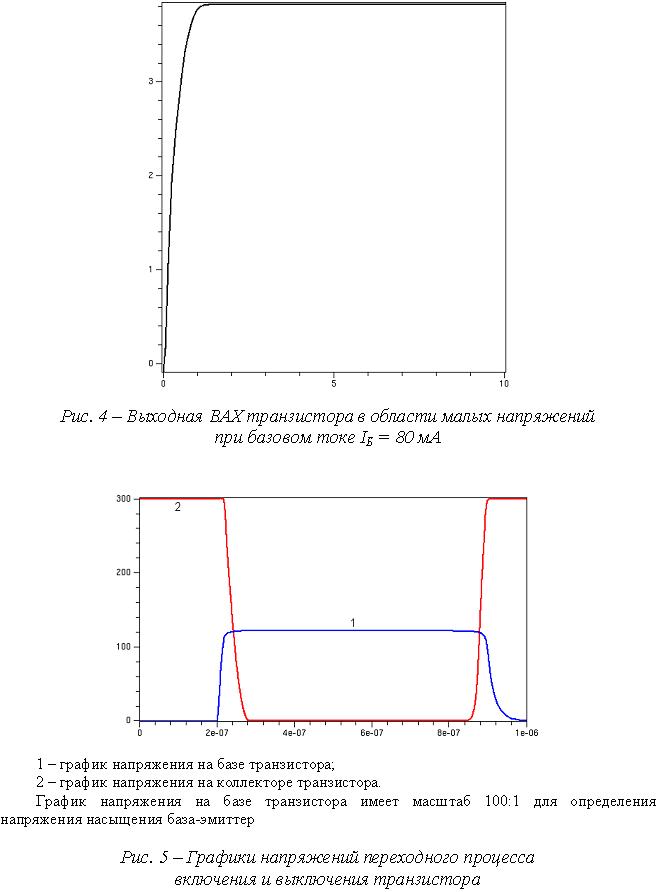
Напряжение насыщения коллектор-эмиттер UКЭнас = 0,22 В, что более чем в 2 раза меньше максимального значения, указанного в табл. 1. Напряжение насыщения база-эмиттер UБЭнас = 1,21 В, т.е. немного больше максимального значения, указанного в табл. 1. Связано это с тем, что падение напряжения на арсенидгаллиевом p—n переходе превышает падение напряжения на кремниевом
p—n — переходе при одинаковых плотностях тока.
Время включения tвкл = 0,062 мкс, время выключения tвыкл = 0,093 мкс. Как видно, эти значения в несколько раз меньше значений, указанных в табл. 1.

1 – график базового тока транзистора;
2 – график коллекторного тока транзистора.
Рис. 6 – Графики токов переходного процесса
включения и выключения транзистора
На рис. 7 показаны результаты расчёта и измерения коэффициента передачи тока в схеме ОЭ от частоты. По горизонтальной оси отложен логарифм частоты f в герцах, по вертикальной оси – коэффициент передачи тока в схеме ОЭ h21Э в децибелах. Как видно из графика, частота единичного усиления ‒ fг = 98 МГц. Таким образом, граничная частота существенно превышает значение, указанное в табл. 1.

Рис. 7 – Зависимость коэффициента передачи тока в схеме ОЭ от частоты
Таким образом, в выполненной работе показан результат расчёта и исследования экспериментальных образцов высоковольтных, быстродействующих биполярных n-p-n транзисторов на основе многослойной эпитаксиальной GaAs/AlGaAs гетероструктуры.
Параметры структуры:
n+ подложка ND = 1019 см-3; d = 300 мкм;
эпитаксиальные слои:
1) n слой ND = 1017 см-3; d = 25 мкм;
2) n— слой ND = 5´1014 см-3; d = 20 мкм;
3) p— слой NA = 1017 см-3; d = 0,5 мкм;
4) p+ слой NA = 1018 см-3; d = 0,4 мкм;
5) n+ слой (Al0,3Ga0,7As/GaAs); ND = 5´1017 см-3; d = 1,5 мкм;
6) n+ слой ND = 1019 см-3; d = 3 мкм.
Список литературы:
- А.И. Сурайкин. Быстродействующие GaAs диоды для импульсной преобразовательной техники // IX Международная научно-практическая конференция Евразийского Союза Учёных «Современные концепции исследований», Часть 2, Москва 27-30 декабря 2014 г., Сборник научных работ, № 9, 2014, С. 77-80.
- А.И. Сурайкин, Е.Н. Федотов. Быстродействующие, высоковольтные GaAs диоды для силовой электроники // Электронное периодическое издание «Огарев-online», Технические науки, вып. 22. Режим доступа: .
- Арсенид галлия. Получение, свойства, применение / Под ред. Ф.П. Кесаманлы, Д.Н. Наследова. – М.: Наука, 1973. С. 36-47.
- А.И. Сурайкин, Ю.В. Горячкин. Разработка высоковольтного AlGaAs/GaAs — гетероструктурного биполярного транзистора // Электроника и электрооборудование транспорта. № 3, 2014. ‒ с. 44-47.
- M. Sze, Semiconductor Devices, Physics and Technology, John Wiley and sons, Inc. p. 151, 2005.
- Зи С. Физика полупроводниковых приборов: В 2-х книгах. Кн. 1. Пер. с англ.- 2-е перераб. и доп. изд.- М.: Мир, 1984.
- Шур М. Современные приборы на основе арсенида галлия: Пер. с англ.- М.: Мир, 1991[schema type=»book» name=»ВЫСОКОВОЛЬТНЫЙ AlGaAs/GaAs – ГЕТЕРОСТРУКТУРНЫЙ БИПОЛЯРНЫЙ ТРАНЗИСТОР НА ОСНОВЕ МНОГОСЛОЙНОЙ ЭПТАКСИАЛЬНОЙ СТРУКТУРЫ» author=»Сурайкин Александр Иванович» publisher=»БАСАРАНОВИЧ ЕКАТЕРИНА» pubdate=»2017-04-21″ edition=»ЕВРАЗИЙСКИЙ СОЮЗ УЧЕНЫХ_ 28.03.2015_03(12)» ebook=»yes» ]

